AI芯片新引擎:英特尔首秀EMIB玻璃基板,78mm超大封装、22层堆叠
1 月 23 日,科技媒体 Wccftech 昨日(1 月 22 日)发布博文,报道称在 2026 年 NEPCON 日本电子展上,英特尔首度公开展示集成 EMIB 技术、尺寸达 78mm×77mm 的巨型玻璃芯基板原型。
IT之家注:EMIB 全称为 Embedded Multi-die Interconnect Bridge,官方名称为嵌入式多芯片互连桥接,可以理解为埋在基板里的“高速立交桥”,专门用来连接基板上相邻的两个小芯片,让数据传输像在同一个芯片内一样快。
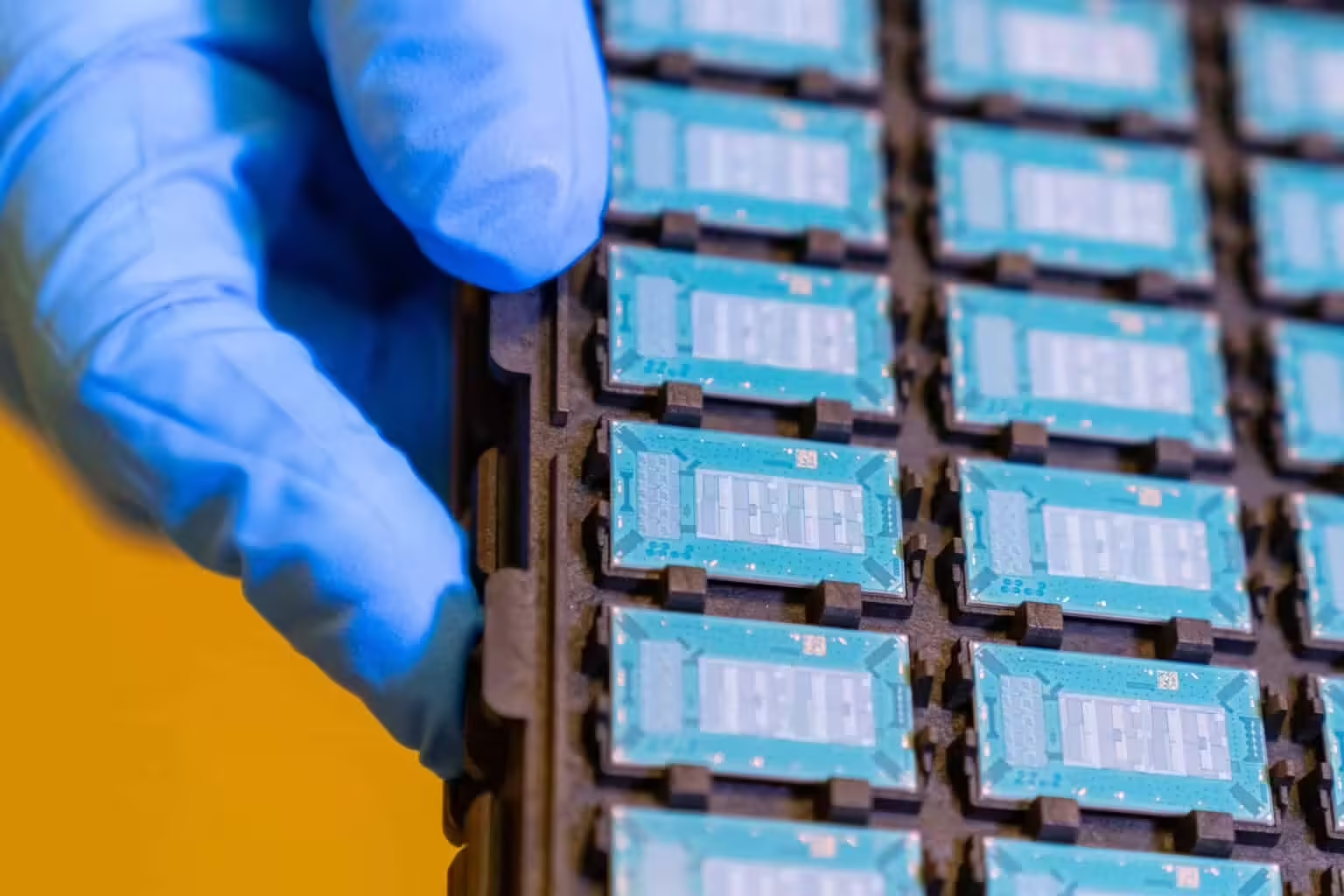
图源:英特尔
为何 AI 芯片必须“弃塑换玻”?
IT之家援引博文介绍,随着 AI 芯片尺寸不断逼近光刻机视场极限(Reticle Limit),传统的有机树脂基板(Organic Substrate)面临严峻的物理瓶颈。
有机材料在高温下极易发生热胀冷缩,导致基板翘曲(Warpage),进而引发芯片接合不良。相比之下,玻璃材料拥有与硅芯片相近的热膨胀系数(CTE),受热后尺寸极其稳定。
此外,玻璃表面极度平滑,支持比有机基板更微细的电路刻蚀,是承载下一代超大算力芯片的理想“地基”。
技术规格方面,英特尔采用了一个尺寸为 78mm x 77mm 的巨型封装,其面积达到了标准光罩尺寸的 2 倍。

图源:英特尔
在垂直截面上,该基板运用了“10-2-10”的堆叠架构:以 800μm(0.8mm)的厚玻璃芯为中心,上下各堆叠 10 层重布线层(RDL),总计 20 层电路用于处理复杂的 AI 信号传输。
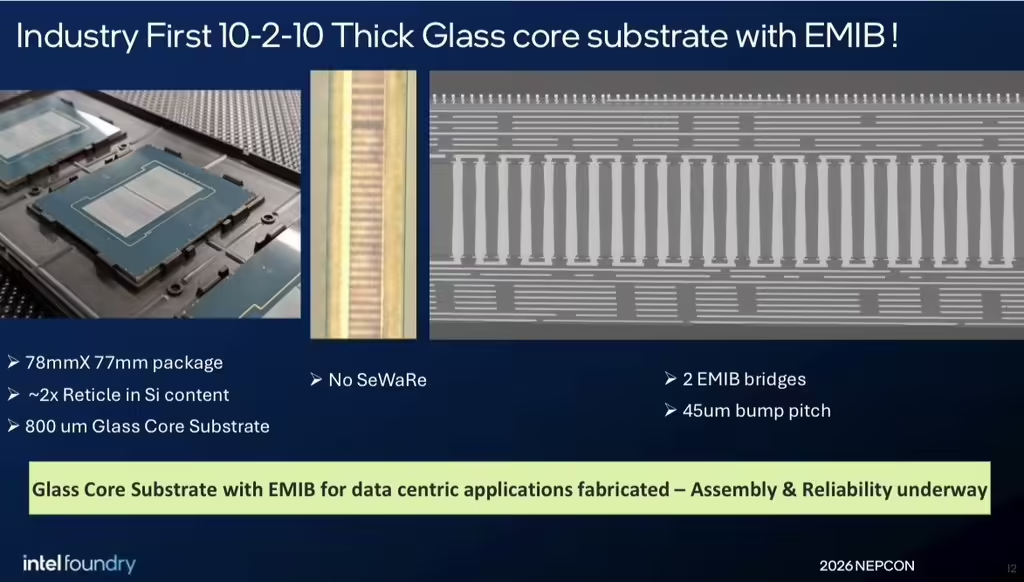
选用 800μm 的“厚芯(Thick Core)”设计,是为了在数据中心的高压环境下确保超大尺寸封装的机械刚性,防止断裂。同时,该基板实现了 45μm 的超微细凸点间距,I/O 密度远超传统基板。
英特尔在此次展示的封装中已成功集成了两个 EMIB 桥接器,验证了玻璃基板在承载复杂多芯片配置时的能力,相比传统有机基板,玻璃基板能提供更精细的互连间距、更好的焦深控制以及更低的机械应力。
业界最关注的焦点在于英特尔明确宣称实现了“No SeWaRe”。SeWaRe 是行业隐语,指代玻璃基板在切割与搬运中极易产生的微裂纹(Micro-cracks),这些隐形伤痕往往会导致封装在热循环测试中彻底碎裂。
英特尔此次的宣示,意味着其已通过特殊的材料改性或加工工艺,彻底解决了玻璃的脆性问题,确保了量产级的可靠性。





- 银行股迎来“黄金买点”?摩根大通预计下半年潜在涨幅高达15%,股息率4.3%成“香饽饽”
- 华润电力光伏组件开标均价提升,产业链涨价传导顺利景气度望修复
- 我国卫星互联网组网速度加快,发射间隔从早期1-2个月显著缩短至近期的3-5天
- 光伏胶膜部分企业上调报价,成本增加叠加供需改善涨价空间望打开
- 广东研究通过政府投资基金支持商业航天发展,助力商业航天快速发展
- 折叠屏手机正逐步从高端市场向主流消费群体渗透
- 创历史季度新高!二季度全球DRAM市场规模环比增长20%
- 重磅!上海加速推进AI+机器人应用,全国人形机器人运动会盛大开幕,机器人板块持续爆发!
- 重磅利好!个人养老金新增三大领取条件,开启多元化养老新时代,银行理财产品收益喜人!
- 重磅突破!我国卫星互联网组网速度创新高,广东打造太空旅游等多领域应用场景,商业航天迎来黄金发展期!




